电子元件行业
引线接合的数码显微系统下的观察、测量
随着第五代移动通信系统(5G)的普及,半导体工件的精细化、高度集成化不断发展,对产品的检测分析需求也越来越高。
下面我们将为您介绍较多使用数码显微系统的引线接合的观察、测量案例。
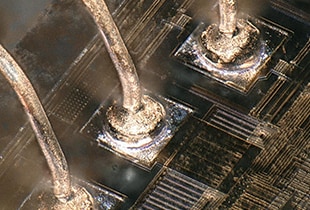
贴装IC芯片的代表性接合方法
- 引线接合
-
利用金、铝、铜等细线连接半导体芯片的电极部与引线框或印刷电路板上导体之间的方法。

- 倒装芯片接合
-
直接将IC芯片连接到印刷电路板上的方法,被称为FC-BGA(Flip Chip-BGA)。在IC芯片的电极部分形成焊点后,与印刷电路板侧的电极相连接。与引线接合相比,能够做到省空间。

- 左:IC芯片
- 右:倒装(正面朝下)
引线接合的流程
-
1. 将金线穿过被称为毛细管的、如同注射针头那样的圆筒后使用。用高电压对引线尖端进行火花放电使其变圆,然后将这个部分与想要连结的电极相接合。我们将这个称为Ball Bonding或1st Bonding。接合通过来自毛细管的负载和超声波以及接合工作台的热量进行。

- A:金线
- B:焊球
- C:IC芯片
-
2. 在完成1st Bonding后移动到2nd Bonding地点之际,连续伸缩接合线,通过毛细管的动作在接合线上形成环形。

- 3. 在与引线电极的连接下,不形成焊球而通过毛细管挤压打线后接合。我们将这个接合称为Stitch Bonding或2nd Bonding。
-
4. 关闭打线夹具,夹住金线固定,提升毛细管后切断打线。

毛细管尖端部的名称
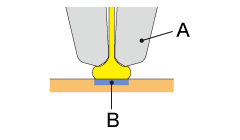
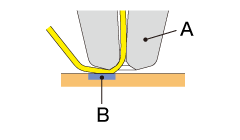
- A:毛细管
- B:接合部
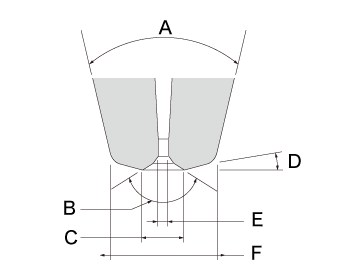
- A:圆形角
- B:倒角
- C:倒角直径
- D:面角
- E:焊球直径
- F:尖端直径
数码显微系统下的引线接合的观察、测量案例
将为您介绍使用基恩士的4K数码显微系统“VHX系列”,对引线接合进行图像观察、测量的新案例。
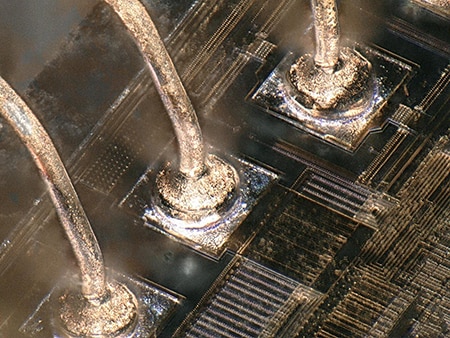
1000× 同轴落射照明
使用深度合成功能,
在高倍率下也可以轻松对焦。


1000× 左:同轴落射照明
右:Optical Shadow Effect Mode图像
利用Optical Shadow Effect Mode,
能够清晰地观察到断裂面的凹凸。

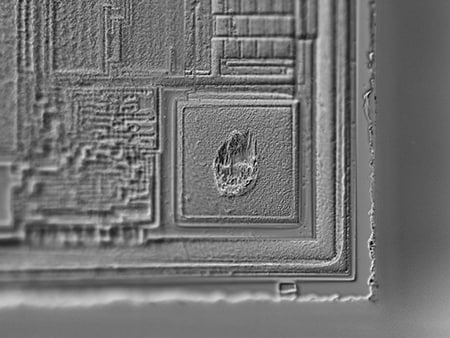
1000× Optical Shadow Effect Mode图像
利用Optical Shadow Effect Mode,
能够清晰地观察到断裂面的凹凸。


